記者陳苗生/綜合報導
AI晶片設計愈來愈複雜,瓶頸卻常卡在晶片彼此怎麼連接、如何散熱。晶圓級多晶片模組封裝(WMCM)正是把多顆晶片拉得更近、把系統先整合起來的技術,被視為手機與高效運算下一波封裝升級重點。
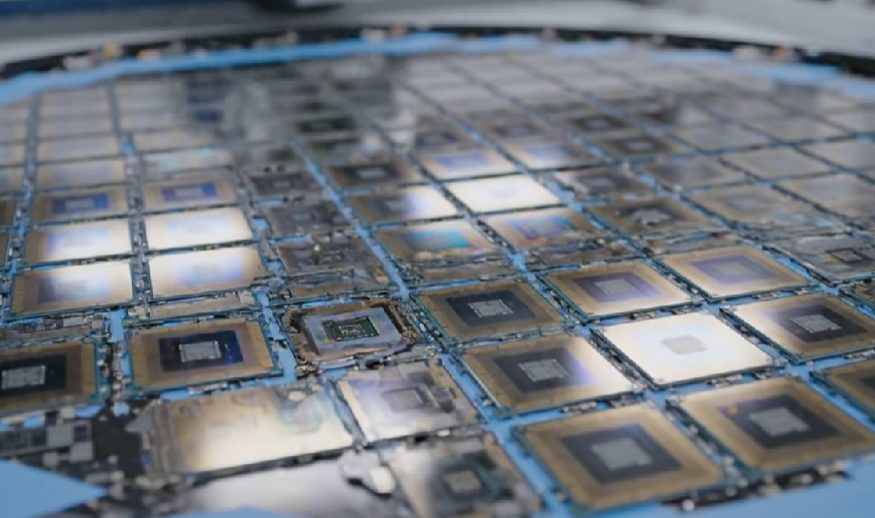
晶圓級多晶片模組封裝的原理,是先在一大片晶圓上把多顆晶片排成一組,透過重布線層把它們的連接線路先做好,再切割成一顆顆出貨。和過去把晶片各自裝進封裝再互相溝通相比,晶片距離縮短後,資料傳輸路徑更短、效率更好。
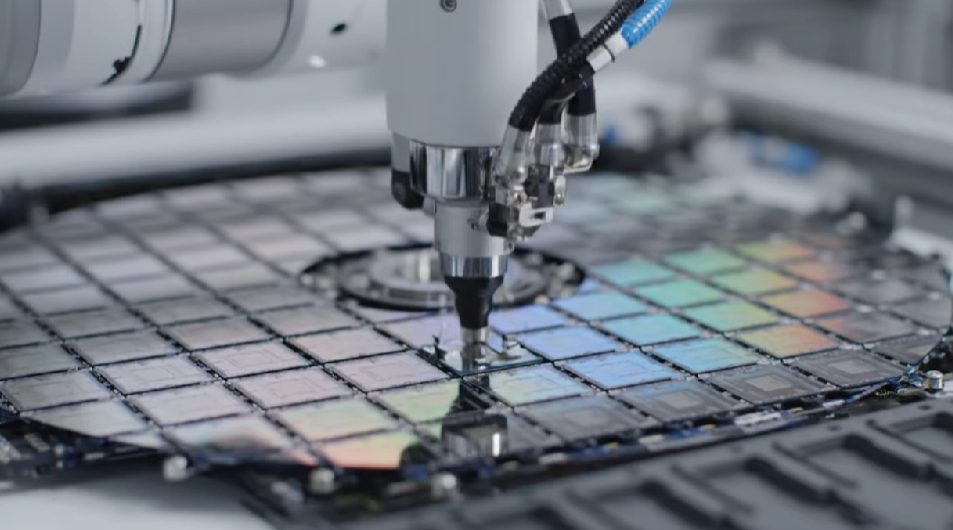
供應鏈角色分工上,業界點名,台積電將是帶頭推進晶圓級多晶片模組封裝量產與擴產的主角。後段測試與設備鏈也相當關鍵。供應鏈傳出,台積電後段晶圓級測試與成品測試將由策略夥伴分工協力,其中,日月光投控與精材具備先行布局與策略夥伴優勢,精材更有望承接相關測試需求。
設備端方面,志聖已取得台積電晶圓級多晶片模組封裝製程設備訂單並開始出貨;弘塑也被點出新增相關業務,可望貢獻營收;辛耘則聚焦高階封裝設備需求升溫;均華也傳出已卡位晶圓級多晶片模組封裝等製程,並掌握晶片分類機訂單。(圖片/新聞來源:經濟日報/工研院/產業科技國際策略發展所)






